- ホーム
- 外販事業
半導体故障解析
設計経験者にしか見えないものがある。
開発経験者だからこそ分かることがある。
半導体故障解析受託サービスの特長
半導体IDMとして長年培ってきた設計・製造のノウハウを基に、豊富な解析経験を活かし、半導体故障解析における電気的特性から物理解析まで一貫した請負体制をご提供しています。特に不良箇所の特定においては、エミッション解析、IR-OBIRCH解析、ナノプローブ解析、EBAC解析、テスターリンク解析などの高度な技術を駆使し、物理解析のさらなる精度と効率の向上を実現します。自社に解析環境を持たないお客様や、手間のかかる部分を委託したいお客様に対し、半導体IDMとしての豊富な経験と専門知識を活かしたスピーディーかつ高品質な故障解析受託サービスをご提供いたします。
対応デバイス
Power Device
- MOSFET
- IGBT /FRD
- SiC/GaN
- 各種ダイオード
センサー
- 加速度センサー/加圧センサー
- AFセンサー
- イメージセンサー
- ラインセンサー
- リニアーセンサー
SoC
- アナログIC
- デジタルIC
- ミックスドシグナルIC
メモリ
- Flash
- EEPROM
- SRAM
- DRAM
この他にもモジュール品の解析など、半導体製品を中心としたさまざまな故障解析に対応しております。
※本サービスは東芝製以外の半導体製品が対象となります。
※東芝製半導体製品につきましては、ご購入先窓口、またはお近くの東芝国内営業窓口へご相談願います。
設計・製造に精通した開発者の目で、半導体の故障を解析

私たちは、設計から製造までの工程を深く理解しています。この豊富な知識と経験を活かし、スピーディーかつ高精度な半導体故障解析を実現しています。
専門知識と豊かな経験を融合することで、設計段階での微細な問題から製造過程での不具合まで、故障箇所を絞り込みます。また、最新の解析技術と長年の経験を駆使し、問題解決に向けた最適なアプローチをご提供しています。
私たちは単なる解析サービス提供者ではなく、お客様のパートナーとして共に課題解決に取り組み、設計・製造の全工程を熟知した技術者の目で、より良いソリューションをご提案します。
半導体の故障を解析する4つのソリューション
東芝デバイスソリューションでは、東芝半導体製品の故障解析で培った解析ノウハウを活かし、一貫した解析から個別解析、コンサルティングまで、さまざまなソリューションをご提案します。
一貫した故障解析
解析サンプルの不良再現から、故障箇所特定、物理解析・成分分析まで一貫した半導体故障解析ソリューションをご提案します。
解析フローと対応可能な解析内容
パッケージ開封などの前処理から、テスターを使った電気的特性評価、各故障モードに沿った故障箇所特定、原因究明のための物理解析など、さまざまな半導体故障解析サービスメニューを取り揃えています。
半導体製品の故障モードに合わせた、より良い故障解析手法をご提案します
前処理
- モールド樹脂開封
- ポリイミド膜剥離処理
- パッケージからのチップ取り出し
- FIB加工(Pad作成/回路修正)
【 500KB/1ページ】
500KB/1ページ】
電気的特性取得
- LSIテスターによる不良再現
- 半導体パラメーターアナライザーによる特性評価
故障箇所特定
ショート・リーク故障(DC故障)解析
動作故障・タイミング故障(FC/AC故障)解析
物理解析
平面解析
- Layer解析
- 平面SEM(走査型電子顕微鏡)解析
- 平面TEM(透過型電子顕微鏡)解析
- オージェ分析、EDX分析(成分分析)
- SIMS分析(二次イオン質量分析)
断面解析
- スライス&ビュー解析
- 断面SEM解析
- 断面TEM解析
- SSRM分析(走査型広がり抵抗顕微鏡分析)
- SNDM分析(走査型非線形誘電率顕微鏡分析)
テスターリンクによる故障解析
テスターリンク解析とは、テスター環境を構築しテストを実行することで、回路を不良状態に設定し不良再現を行う解析手法です。不良モードに合わせ最適な解析装置を組み合わせることで半導体製品の故障箇所を効率的に特定します。
テスターリンク解析の特長
・テスターで動作状態を維持したまま、不良モードに合わせた解析装置を選択し故障箇所を絞り込むことが可能です。
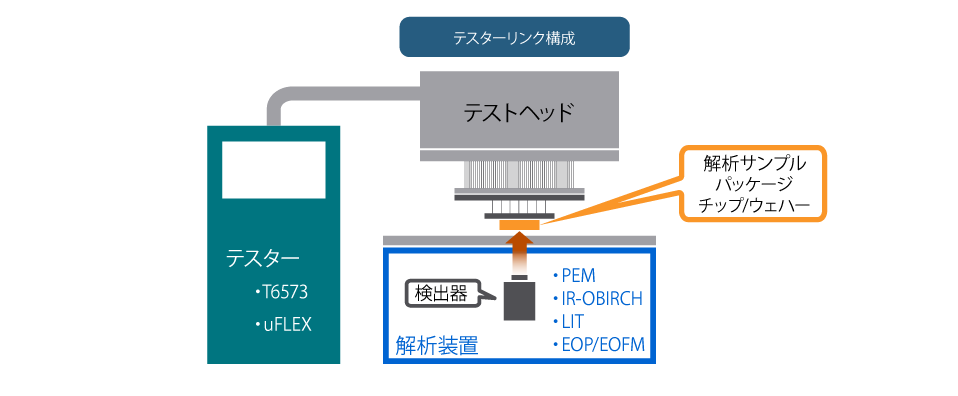

・解析サンプルはチップやウエハー、パッケージの状態のどちらでも対応可能です。
・お客様からテストパターン情報をご提供いただき、当社にて解析に使用するテスターに合わせたテストプログラムに変換いたします。
・実機ボード、ブレッドボードによる解析も可能です。
テスターリンク解析環境による解析
複数の解析手法を組み合わせたテスターリンク解析環境を活用し、テスターを使って回路を動作させながら解析を行うことで、これまでスタティックな状態では再現が難しかった故障を再現させやすくします。また、得られたテスト結果と解析結果を組み合わせて総合的に判断をすることで、より精度良く故障箇所を特定することが可能となります。

ナノレベルの絞り込みによる故障原因の追及
ナノプローブ装置などを使用した優れた故障箇所特定技術で、ナノレベルの絞り込みをご提供します。
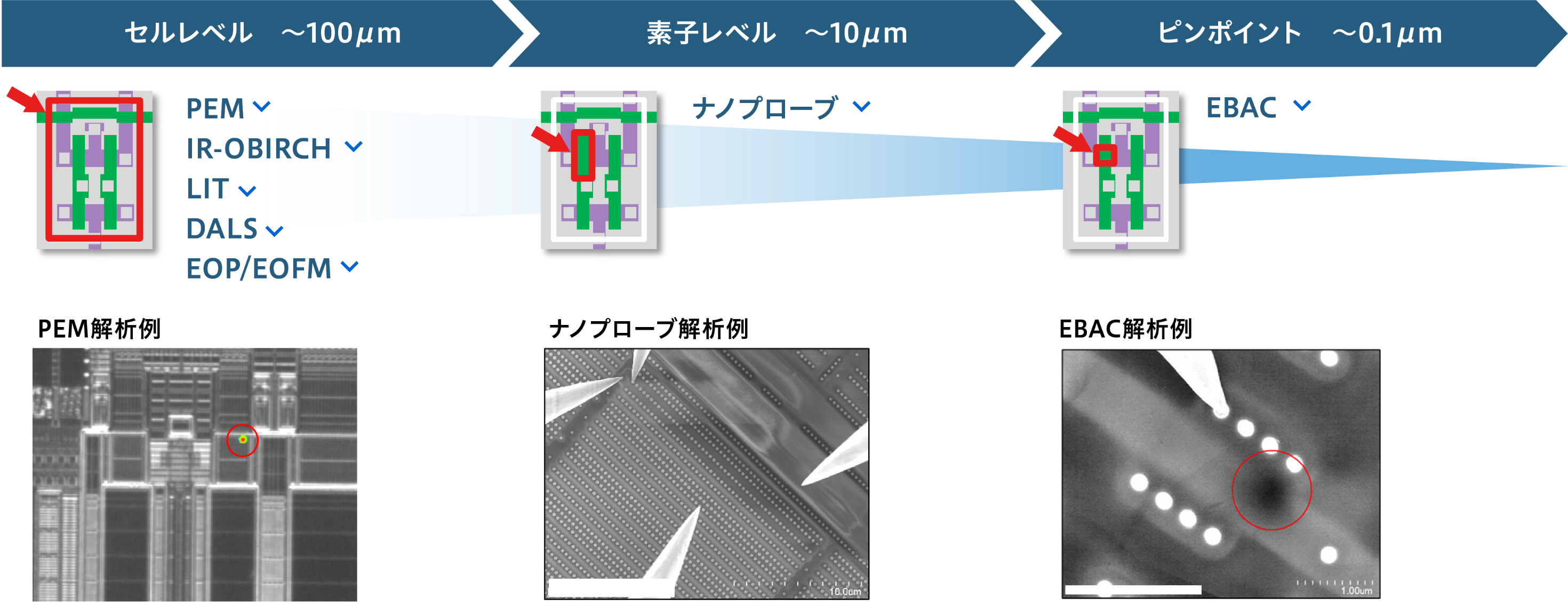
写真提供:東芝デバイス&ストレージ株式会社/株式会社ジャパンセミコンダクター
ナノプローブ解析とは
SEMとプロービング装置が一体となったナノプローブ装置を使って、LSI中の単体トランジスターの電極に直接コンタクトを行い、素子の電気特性を測定します。電圧-電流特性から異常の有無や正常素子との比較により、不良の原因となる特性の変動などを調べます。
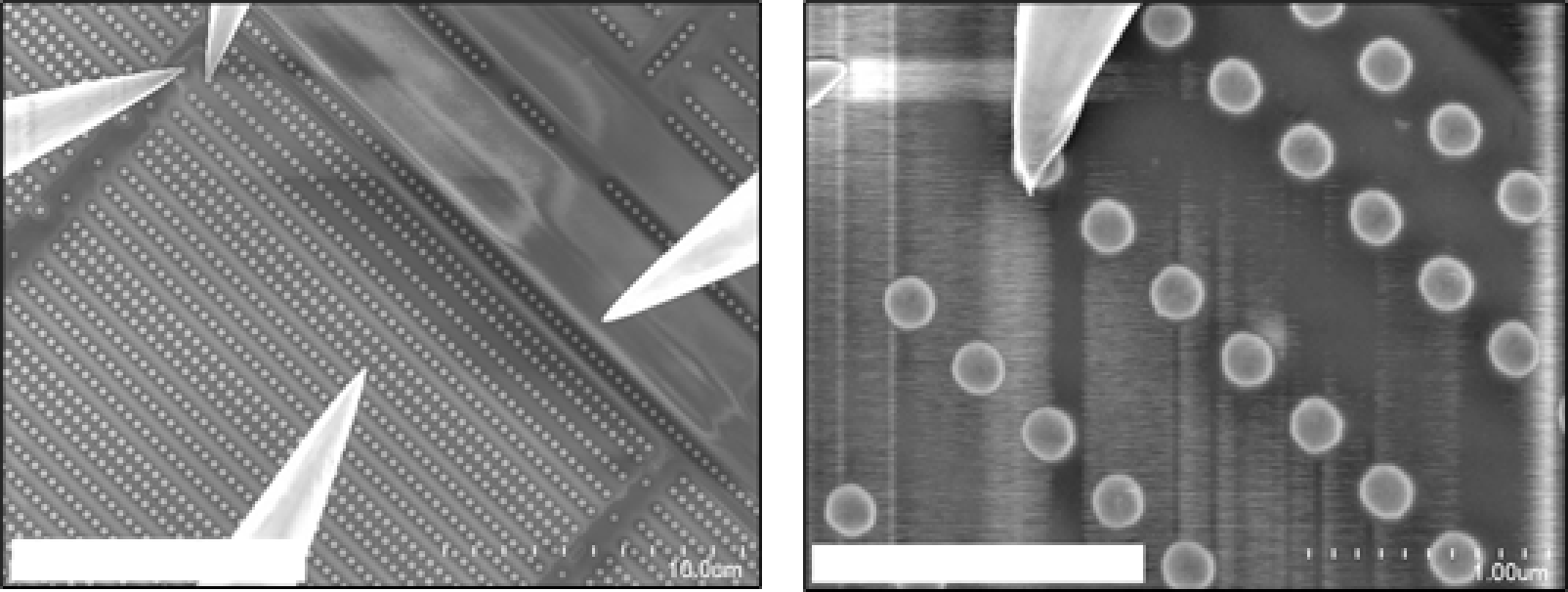
写真提供:東芝デバイス&ストレージ株式会社/株式会社ジャパンセミコンダクター
1. 特長
- ナノプローブは、非常に小さな領域に対して高精度な電気的測定を行うことができるため、微細なトランジスタや配線の特性を詳細に解析でき、従来の手法では見つけにくい微細な故障箇所を絞り込むことができます。
- 当社のナノプローブ解析では、最大8電極を使用したプロービングを行うことができます。また、測定温度は-40℃~150℃ の範囲で測定可能です。
2. ナノプローブ解析の仕様
- 解析可能プロセス:16nmまでのプロセスについて測定実績があります。
*16nmより微細なプロセスの測定につきましては、当社解析担当までご相談ください。 - 測定可能サンプルサイズ:10mm/厚さ1mm以下
*ご提供いただくサンプルが上記サイズを超える場合は、弊社にて上記サイズに加工後に測定を行う場合がございます。
EBAC(Electron Beam Absorbed Current)解析とは
EBAC解析は、電子ビーム電流吸収法にて欠陥を特定します。ナノプローブ(SEMレベル)設備へEBACアンプを接続させることで、伝送経路上での欠陥やトランジスタの微少リーク箇所を検出する解析手法です。

写真提供:東芝デバイス&ストレージ株式会社/株式会社ジャパンセミコンダクター
1. 特長
EBAC解析には故障モデルに合わせて3つの手法があります。
- 吸収電流EBAC:配線オープン箇所特定
- 差動EBAC:配線高抵抗箇所特定
- DI-EBAC:リーク箇所特定
2. EBAC解析の仕様
- 試料サイズ:10mm/厚さ1mm
- 温度環境:ー40℃~+150℃
- 加速電圧:0.8keV~25keV
- EBACアンプ:±10V
- その他印加電圧:±30V
PEM(Photo Emission Microscopy )解析とは
PEM解析は、半導体の発光現象を捉える装置です。トランジスタのキャリア再結合時に発生するフォトン(光)を、高感度検出器にて画像採取を行います。
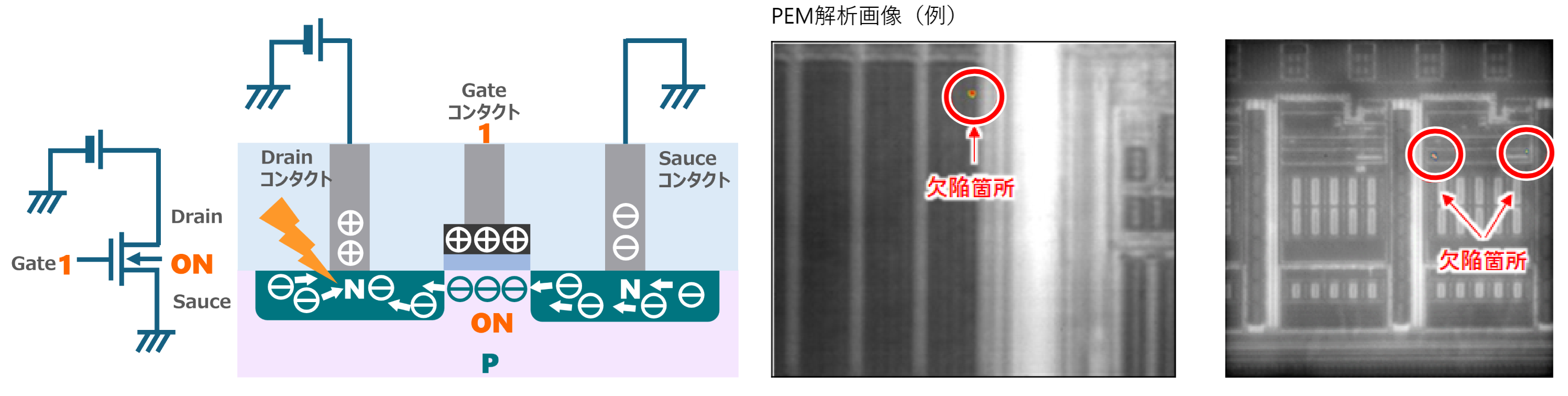
写真提供:東芝デバイス&ストレージ株式会社/株式会社ジャパンセミコンダクター
1. 特長
以下の故障モデルに有効です。
- トランジスタ内のリーク不良(ゲート酸化膜異常やPoly形成異常など)
- 発光箇所出力配線での配線間ショート不良
- 発光箇所入力配線のオープン/高抵抗不良
2. PEM解析の仕様
- 観察方向:表面/裏面の双方に対応
- 温度環境:常温のみ
- 試料状態:パッケージ/チップ/ウエハーに対応
- LSIテスターとのリンク:テスターで所望動作を行い発光観察が可能
- 涸浸レンズ:利用可能(ウエハー裏面からの観察)
IR-OBIRCH(InfraRed Optical Beam Induced Resistance Change)解析とは
IR-OBIRCH解析は、温度による電流変動を捉える装置です。赤外線レーザーの照射にて局所的に熱を与え、その時の電流変動箇所を画像化します。
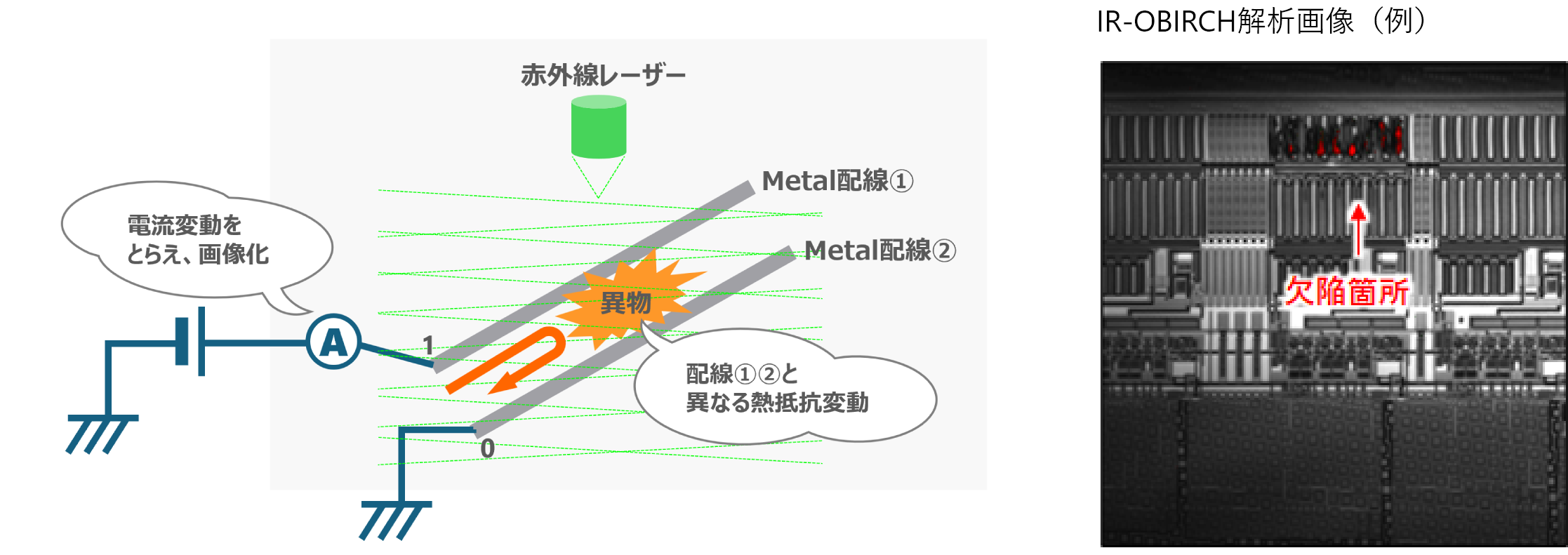
写真提供:東芝デバイス&ストレージ株式会社/株式会社ジャパンセミコンダクター
1. 特長
以下の故障モデルに有効です。
- ショート不良
- 微少リーク不良
2. IR-OBIRCH解析の仕様
- 観察方向:表面/裏面の双方に対応
- 温度環境:常温のみ
- 試料状態:パッケージ/チップ/ウエハーに対応
- LSIテスターとのリンク:テスターで所望動作を行い熱電流変動を観察
- 印加電圧:±10V(300mA)/微少電流±25V(100uA)
- 涸浸レンズ:利用可能(ウエハー裏面からの観察)
LIT(Lock-in Thermal Emission Microscopy)解析とは
LIT解析は、パルス電源を印加して発熱箇所を捉える装置です。パルス印加時の発熱画像のみを抽出することで、熱拡散の影響を最小限にして発熱箇所を絞り込みます。

写真提供:東芝デバイス&ストレージ株式会社/株式会社ジャパンセミコンダクター
1. 特長
以下の故障モデルに有効です。
- ショート不良
- 深さ方向の位置情報も得られる
2. LIT解析の仕様
- 観察方向:裏面
- 温度環境:常温のみ
- 試料状態:パッケージ/チップ/ウエハーに対応
- LSIテスターとのリンク:テスターで所望動作を行い熱電流変動を観察
EOP(Electro-Optical Probing)/EOFM(Electro-Optical Frequency Mapping)解析とは
EOP解析は、チップ裏面から観察Drain部へ非コヒーレント光を照射し反射率から波形を生成させる装置です。
EOFM解析は、指定した周波数を基準とした位相マッピングを画像化します。EOP/EOFMは共にファンクション不良やタイミング不良解析に利用します。
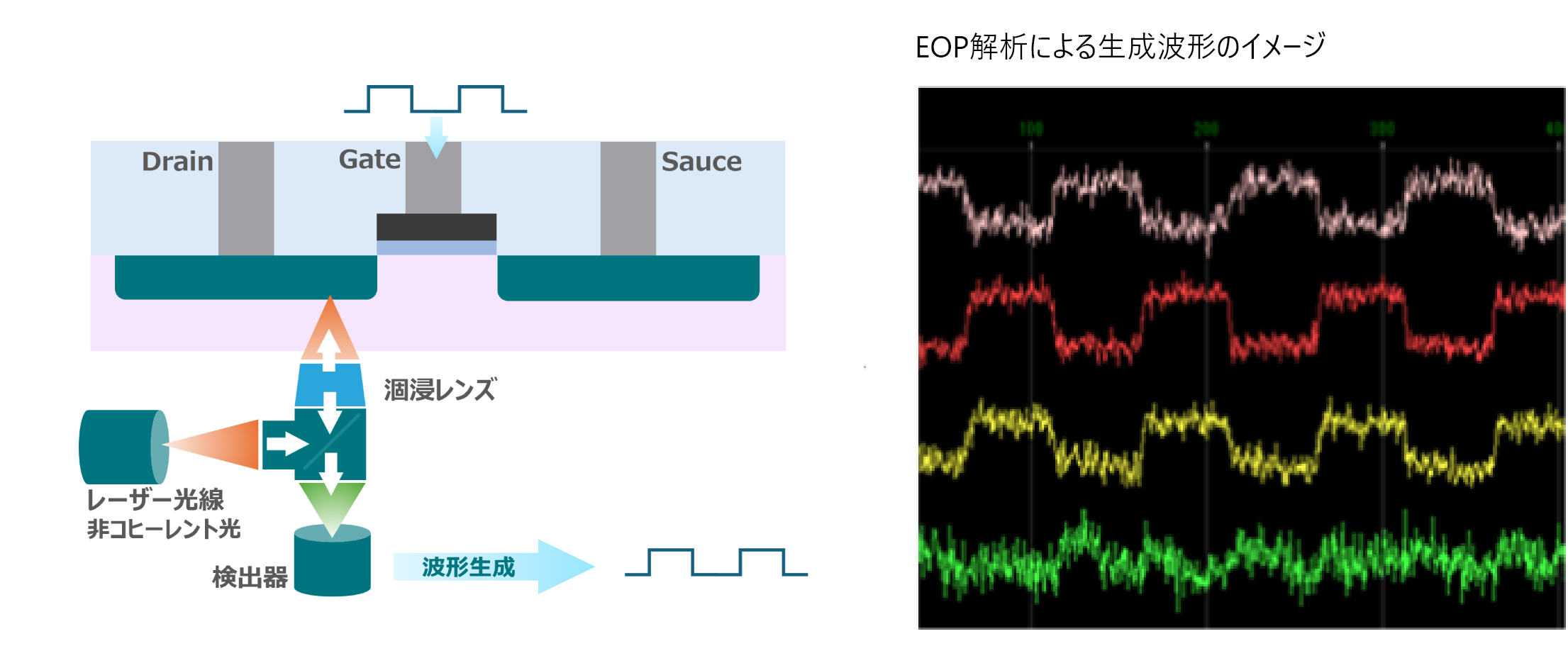
写真提供:東芝デバイス&ストレージ株式会社/株式会社ジャパンセミコンダクター
1. 特長
それぞれの装置では以下のことが行えます。
- EOP:非接触で半導体内部波形を観察
- EOFM:非接触で周波数マッピングを画像化
2. EOP/EOFM解析の仕様
- 観察方向:裏面
- 温度環境:常温のみ
- 試料状態:パッケージ/チップ/ウエハーに対応
- LSIテスターとのリンク:テスターで所望動作を行い観察
- 涸浸レンズ:利用可能(ウエハー裏面からの観察)
DALS(Dynamic Analysis by Laser Stimulation)解析とは
DALS解析は、動作状態にて赤外線レーザーを照射し局所的に熱を与え、動作状態の変化を捉える装置です。
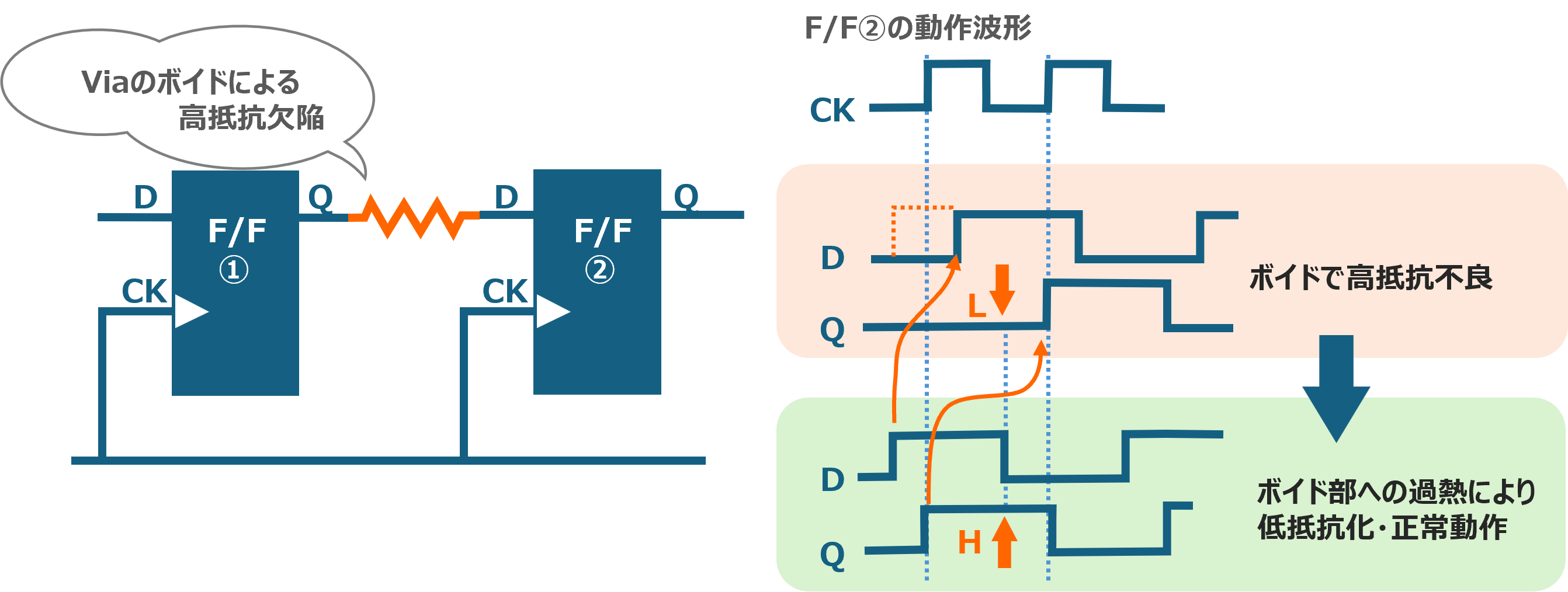
1. 特長
以下の故障モデルに有効です。
- ビア/コンタクトのボイドを原因とする高抵抗によるタイミングマージン不良
- 設計的にタイミングマージンが厳しい箇所の絞り込み
2. DALS解析の仕様
- 観察方向:表面/裏面
- 温度環境:常温のみ
- 試料状態:パッケージ/チップ/ウエハーに対応
- LSIテスターとのリンク:テスターで所望動作を行い観察
- 涸浸レンズ:利用可能(ウエハー裏面からの観察)
歩留まり向上
半導体ウエハーの歩留まり分析やテスター評価の結果から、解析手法をご提案
故障解析の専門チームは、半導体ウエハーの歩留まり分析やテスター評価の結果をもとに、解析手法をご提案します。これにより、製造プロセスの効率化と品質向上のお手伝いをいたします。
故障解析の結果から改善施策をご提案
故障解析の結果を詳細に分析し、具体的な改善施策をご提案します。これにより、製品の信頼性を向上させ、歩留まりの向上をサポートします。
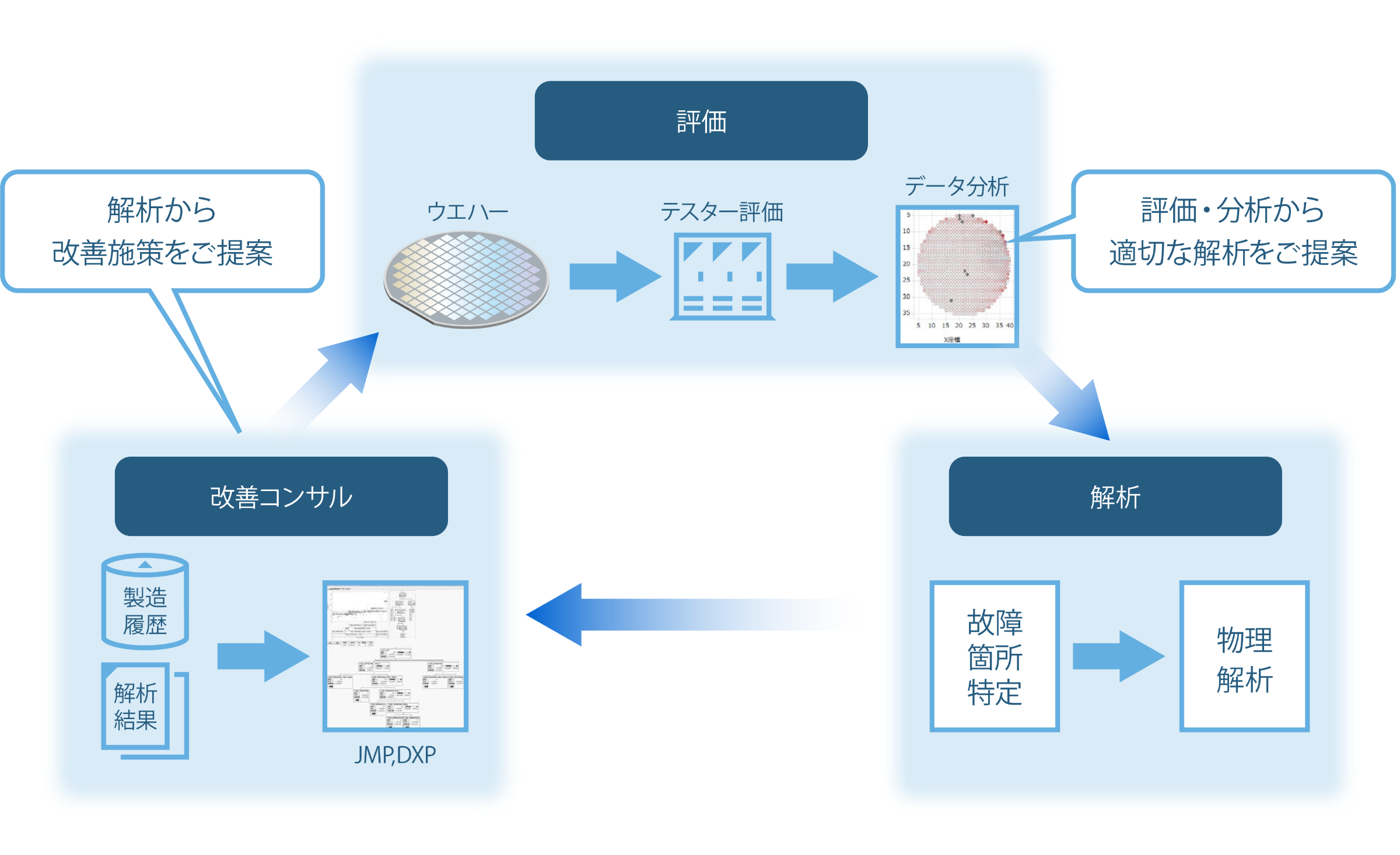
※東芝製半導体製品につきましては、ご購入先窓口、またはお近くの東芝国内営業窓口へご相談願います。


